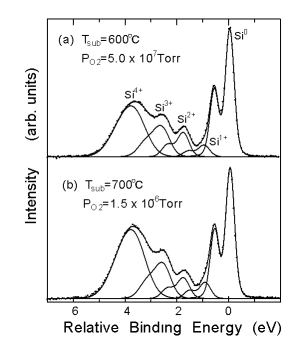
恾侾丂Si2p撪妅弨埵僗儁僋僩儖丅椼婲岝偺僄僱儖僊乕偼135eV丅

恾俀丂巁壔儌僨儖丅
恾侾偼巁慺偵傛傞擬巁壔枌偺Si2p撪妅弨埵僗儁僋僩儖偱丄巁壔壏搙偑俇侽侽亷偲俈侽侽亷偱偁傞丅 巁壔枌岤偼栺俆僆儞僌僗僩儘乕僌偱偁傞丅嵟彫擇忔朄偵傛傞僺乕僋僼傿僢僥傿儞僌傪峴偭偨寢壥傪 幚慄偱帵偟偰偍傝丄僶儖僋埲奜偵係偮偺壔妛僔僼僩惉暘偱峔惉偝傟偰偄傞偙偲偑暘偐傞丅偡側傢偪 僶儖僋惉暘乮Si侽乯丄俁偮偺僒僽僆僉僒僀僪惉暘乮Si1+丄Si2+丄 Si3+乯丄SiO2惉暘乮Si4+乯偱偁傞丅偦傟偧傟偺惉暘偼恾俀偵帵偡傛偆偵丄巁慺偲偺 寢崌悢偺堘偄偵傛偭偰惗偠偨傕偺偱偁傞丅
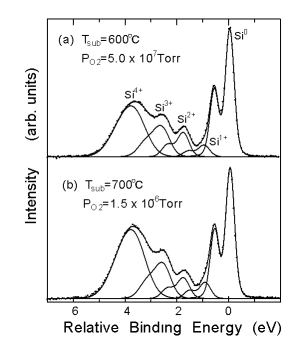 恾侾丂Si2p撪妅弨埵僗儁僋僩儖丅椼婲岝偺僄僱儖僊乕偼135eV丅 |
 恾俀丂巁壔儌僨儖丅 |
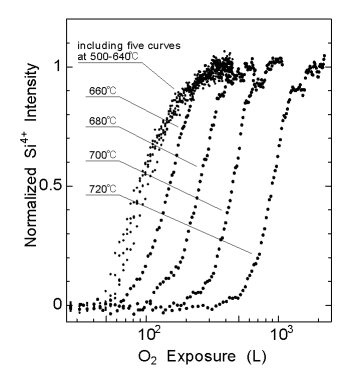 恾俁丂條乆側壏搙偱偺巁壔懍搙偺朶業検埶懚惈丅 |
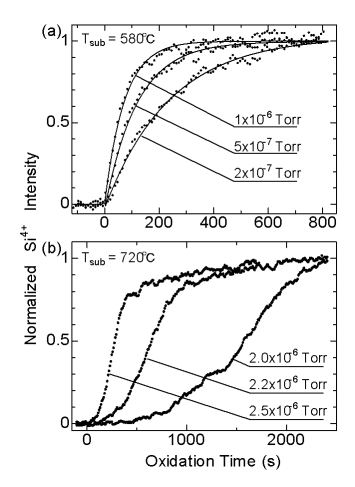 恾係丂俆俉侽亷偲俈俀侽亷偱偺巁壔懍搙偺帪娫曄壔丅 |
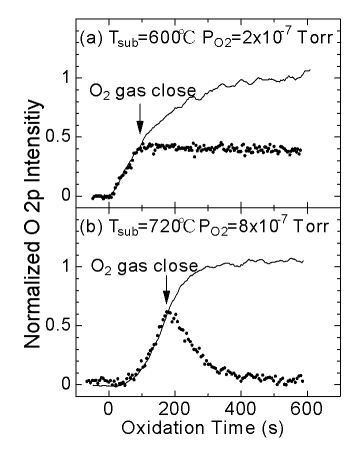 恾俆丂巁慺摫擖掆巭偵傛傞巁壔嬋慄偺曄壔丅(a)掅壏椞堟偺俇侽侽亷(b)崅壏椞堟偺俈俀侽亷 |

|
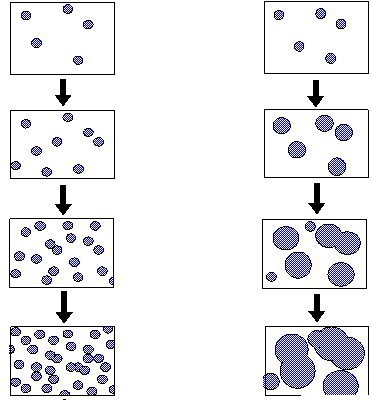 恾俇丂掅壏椞堟偲崅壏椞堟偺巁壔斀墳儌僨儖丅 |
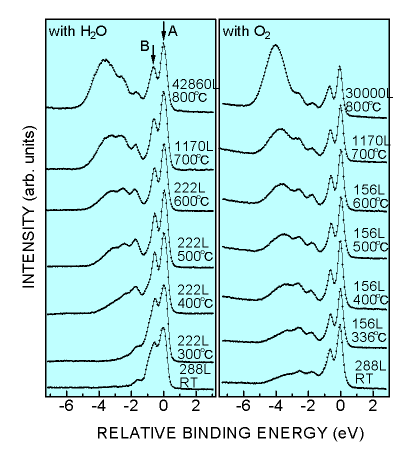 恾俈丂僂僃僢僩巁壔偲僪儔僀巁壔偵傛傞巁壔枌偺Si2p撪妅弨埵僗儁僋僩儖丅椼婲岝偺僄僱儖僊乕偼135eV丅 |
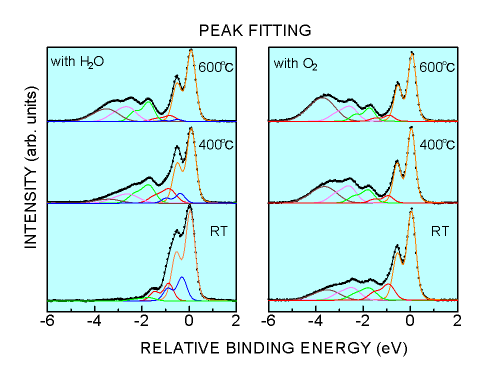 恾俉丂恾俈偺僗儁僋僩儖傪僼傿僢僥傿儞僌偟偨寢壥偺戙昞僗儁僋僩儖丅 |
 恾俋丂Si-H惉暘嫮搙乮崟娵乯偲僄僱儖僊乕僔僼僩乮愒娵乯偺巁壔壏搙埶懚惈丅 |
 恾侾侽丂僪儔僀巁壔乮愒娵乯偲僂僃僢僩巁壔乮崟娵乯偺Si4+嫮搙偺巁壔壏搙埶懚惈丅 |
 恾侾侾丂僂僃僢僩巁壔偺斀墳儌僨儖丅 |
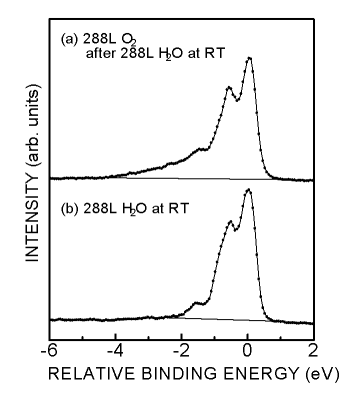 恾侾俀丂幒壏偱悈傪朶業偝偣偨昞柺乮壓乯偲偙偺昞柺偵偝傜偵巁慺傪朶業偝偣偨昞柺乮忋乯偺Si2p撪妅弨埵 僗儁僋僩儖丅 |